
2026 年 5 月 5-7 日,聚焦东南亚半导体产业发展的国际盛会 ——SEMICON SEA 2026将在马来西亚国际贸易展览中心盛大启幕。作为东南亚地区极具影响力的半导体专业展会,本届展会汇聚全球领军企业,围绕先进封装、晶圆制造等核心领域展开深度交流,是链接东南亚市场、洞察区域产业机遇的关键平台。
铭赛科技此次携半导体先进封装解决方案亮相SEMICON,依托精密点胶、精密贴装、水导激光三大产品线,覆盖底部填充、芯片散热贴装、高硬脆材料精密加工等关键场景,同时展出多款自主研发的高稳定性流体控制与制程核心部件,为半导体先进制造提供可靠的设备支持。
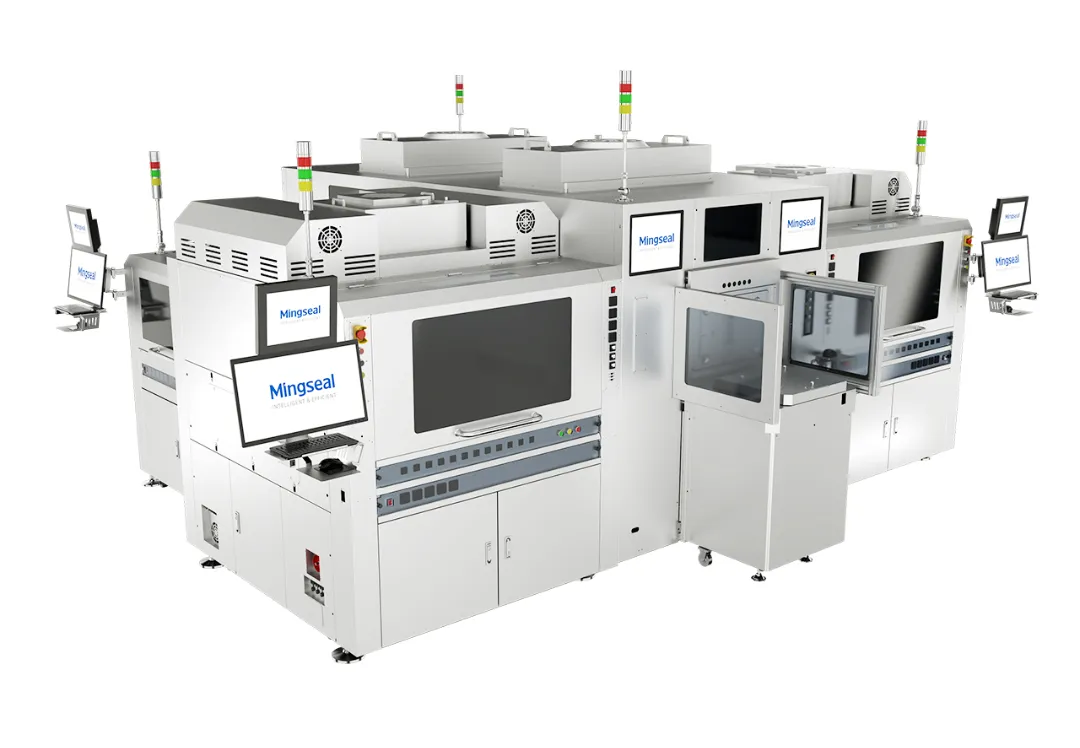
SS300 面板级点胶系统
专为RDL First FOPLP底部填充工艺打造的高稳定高精度Panel级点胶平台,集自动上下料、对位、预热、抗翘曲、喷胶、AOI 检测于一体。支持PGV/AGV/OHT自动上下料,适配先进封装产线的无人化、信息化管理需求。

SS101 晶圆级点胶系统
面向CoWoS、FoWLP等先进制程的晶圆级喷胶系统,集成晶圆自动上下料、预热、加热、喷胶、散热全流程功能。配置AMHS机器人接口,满足8/12 英寸晶圆规模化生产,适配晶圆级封装的高精度、高稳定性要求。

GS600SUA 底部填充点胶机
专为 FCBGA、FCCSP、SiP 等倒装芯片封装的底部填充工艺设计,高精度全自动在线式喷胶设备。点胶精度达 ±0.02mm,矿物质框架结构保障高速运行稳定性;双轨并行 + 三段加热提升产线效率,支持 PDI 在线检测、胶形 AOI 检测,可对接 MES 系统,适配封装企业量产需求。
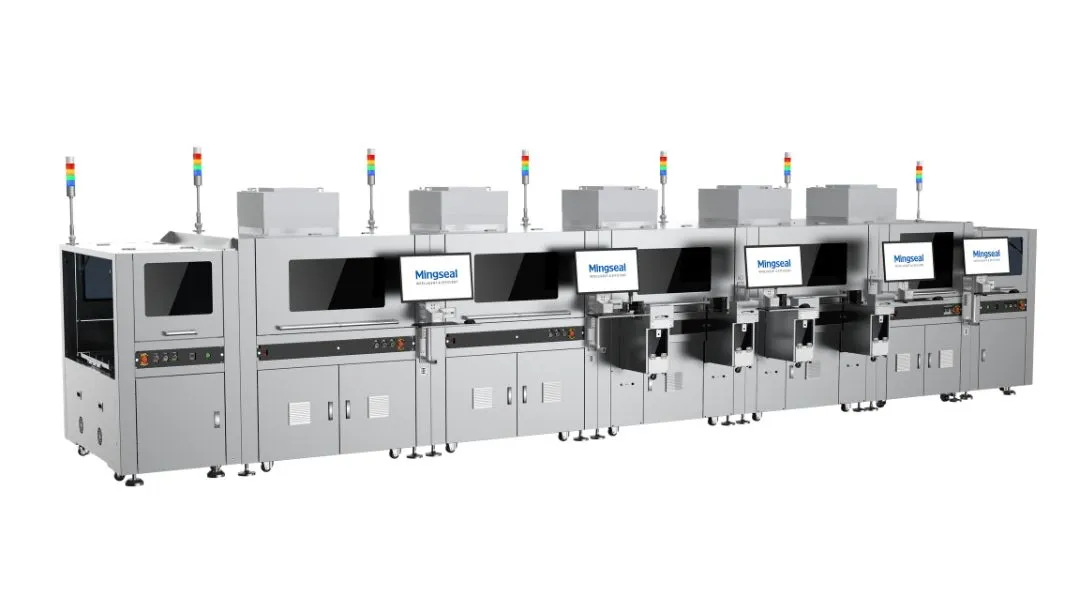
SS400 芯片散热贴装系统
针对TIM1/TIM2高效散热场景,支持导热硅脂、铟片、石墨烯、金刚石等多种散热材料贴装。兼容大尺寸 FCBGA、Q-Panel 连板作业,配套助焊剂喷涂、围坝填充工艺,是功率器件、AI 芯片散热集成的优选方案。

SS200 全自动散热盖贴装系统
专为 FCBGA/FCCSP Lid Attach 工艺打造的高稳定性高精度贴装系统,集自动上下料、AD/TIM 胶点胶、Lid 贴装、保压预固化、多环节检测于一体,实现一站式自动化作业。具备点胶位置自动补偿、智能防呆功能,模块化设计支持多种选配模块,兼容多种上料方式,适配多样化产线需求。

MLS300 超精密加工系统
面向陶瓷、碳化硅、金刚石等高硬脆材料,提供平面高精密开槽、打孔、切割等加工方案,满足先进封装与功率器件制造的材料加工需求。加工精度达±10μm、热影响区≤5μm、最小切割缝隙仅30μm,突破传统加工技术局限,实现材料无毛刺、高质量加工。
半导体精密制造的价值,在于对制程稳定性与一致性的极致坚守。铭赛科技持续深耕半导体封装与高端装备领域,不断实现精度、效率与可靠性的迭代突破。我们期待与东南亚及全球业界伙伴深入交流、携手合作,共同把握半导体封装领域的发展机遇!
时间:2026年5月5-7日
地点:马来西亚国际贸易展览中心(MITEC),吉隆坡
展位号:2216,Hall 8
